产品
FIB-SEM
Nanomanipulators
OmniProbeOmniProbe Cryo软件
AZtec3DAZtecFeatureAZtec LayerProbeTEM
Hardware
EDSUltim MaxXploreImaging
软件
AZtecTEM
自硅基半导体作为一个规模庞大的产业发 展起来后,集成电路单位面积上晶体管的数量增 加趋势始终遵循摩尔定律111。目前,硅基半导体中 的关键尺寸(线宽或特征尺寸)已经降低到到 10nm 以下121。相比于硅基半导体,化合物半导体 如SiC和GaN 基半导体可以满足更苛刻的工作条 件(高击穿电场、高热导率、高电子迁移率、高工 作温度等),具有更大的输出功率和更好的频率 特性,市场需求方兴未艾。化合物半导体的应用 场景面向射频、高电压大功率、光电子等领域,不 追求硅基半导体级别的先进制程工艺。如GaN 制 程的基本线宽在0.25~0.50 μm, 生产线以4英寸 为主13。

半导体器件结构的微细化演进对电子显微镜 视野下的微区元素分析带来了很大的挑战。在电 子显微镜中,电子束照射在观察区域上,形成水滴 形的相互作用区域,如图1所示。从该区域中会逸 出多种信号,如观察表面形貌的二次电子(SE)、区 分成分衬度的背散射电子(BSE)和分析成分的X射 线。电子显微镜会配置不同的探测器来接收这些 信号进行成像。能谱仪(EDS.Energy Dispersive Spectrometer)以X射线为信号源分析微区成分分 布。图1也显示,这几种信号源的深度不同,SE 最 浅,BSE 次之,X 射线最深。不同信号源的逸出深度 可以解释同样条件下SE、BSE 和EDS 成像的空间分辨率差异。
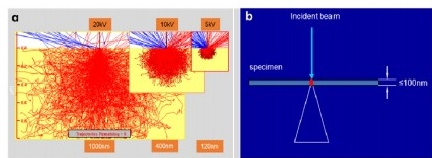
提高EDS 成像的空间分辨率需要减小X 射线的逸出范围,有两种路径可供选择,如图2所示。第一种是降低加速电压,减弱电子束的能量。图2(a)使用Monte Carlo软件模拟不同加速电压下入射电子在纯铁中的扩展范围。20kV、1OkV、5kV 下,入射电子的穿透深度分别约为100Onm、400nm、12Onm。 随着加速电压的降低, X 射>线的逸出范围减小,更多的X 射线来自作用区域的表层,采用合适的观察条件可以使EDS 成像和电子图像中特征物的轮廓重合。可是,加速电降低后,仅有低能量线系的X 射线被激发,产额也会明显减少。为了增加这些低能量X 射线的采集效率, EDS 技术朝着增大硅漂移探测器晶体面积的方向发展。
另一种途径是减小样品厚度,将样品的观察区域减薄至100nm 以内,采用更高的加速电压,如30kV 甚 至 2 0 0kV, 进行EDS 分析,如图2(b)所示。在这种STEM 模式下,高能的电子束穿透薄样品,X 射线信号的逸出区域受到极大的限制。可是,随着加速电压的增加,X 射线的产额也会降低,这是透射电子显微镜(TEM) 上往往选择大面积甚至无窗EDS 探测器Ultim Max TLE的原因。虽然在TEM 中使用EDS 成像可以得到非常高的空间分辨率,但操作复杂,效率低。若非精细结构分析必需,TEM 中 EDS 成像远不如扫描电子显微镜(SEM) 中 的STEM-EDS 模式来的方便。
SEM 中STEM-EDS 分析需要将样品减薄至电子束透明。图3(a)为GaN 晶体管的SE 图像,经 过FIB 均匀减薄后可以清晰地分辨出GaN 晶 体管的源极、漏极和栅极。将样品放置在如图 3(b)所示的TKD 样品台(www.51haocai.cn)即可采集×射线信号,获得高空间分辨率的 EDS 成像。
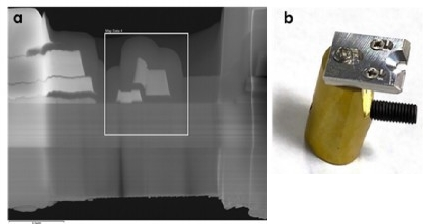
在这种分析模式下,电子束穿透样品,和样 品的相互作用区域减少, X 射线的产额较小,使 用大面积晶体的EDS 探测器可以增加X 射线的 采集效率和低能量X 射线的敏感性。作者使用场 发射SEM 上搭载的Ultim Max 170探测器分析 图 3(a)选区内的元素分布。加速电压为30kV, 放 大倍率为1万倍,仅耗时5分钟采集到的X射线计 数就超过1600万,N、Ga、Si、Au元素的分布如 图4所示。图4使用特定能量范围内的X 射线计数 成像,在该结果中存在假象。SiN 和GaN 中的N K 线系与Ti L线系的能量范围接近,是半导体中常 见的谱峰重叠元素,图4中N 元素局部与Ti元素 重合。此外,在Au 元素分布区域同时存在Ga 元 素。这些假象主要由谱峰重叠和背底引起。高级 功能TruMap 可以扣除背底、剥离重叠谱峰,计算 出各个元素谱峰对应的X 射线计数,给出真实的元 素分布。图5为经过TruMap 处理后的元素分布, N 元素与Ga、Si元素的分布对应良好。Ga、Si元 素局部的不均匀分布源自样品厚度而非元素含 量差异。Au 栅极下方淀积的Ni、Ti层厚度约为60nm。 需要指出的是,Ti层局部观察到O 元素的偏聚。
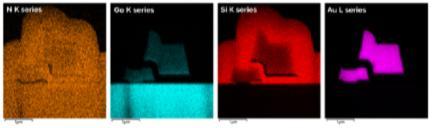
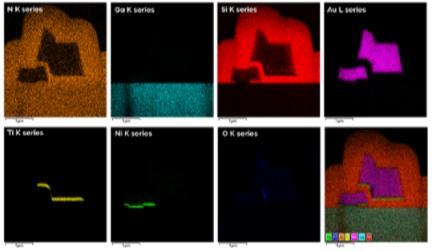
目前,化合物半导体的特征尺寸远大于硅基半导体的先进制程,在SEM 中采用STEM-EDS进行元素成像能够满足空间分辨率的需求。这种方法介于基于SEM 中的低电压元素分析和基于TEM 的STEM-EDS 分析,效率高,成本低,有明显的效费优势。
[1](美)Michael Quirk,(美)Julian Serda著;韩郑生等译.半导体制造技术.北京:电子工业出版社[M],2015.10.
[2]http://news.ustc.edu.cn/info/1055/ 49289.htm
[3]https://www.compoundsemiconductorchina.net/features.asp?id=2208
点击下载应用报告
 公安机关备案号31010402003473
公安机关备案号31010402003473