产品
FIB-SEM
Nanomanipulators
OmniProbeOmniProbe Cryo软件
AZtec3DAZtecFeatureAZtec LayerProbeTEM
Hardware
EDSUltim MaxXploreImaging
软件
AZtecTEM
金属化是制造现代半导体器件不可缺少的一个工序,它将不同的元件连接在一起,也直接影响到器件工作时的性能。如果金属层被氧化,电阻增加,电气联通下降,会造成器件的性能恶化甚至是失效。因此,一旦发现金属层缺陷,寻找其缺陷原因并回溯到制造工艺是一个非常重要的失效分析内容。
图 1 所示,是一个失效的功率器件的金属层结构。该器件首先通过电气性能测试,定位到其失效部位位于 Al 金属层,直接裂片后,在扫描电子电镜(SEM)中观察其截面的形貌和元素分布。
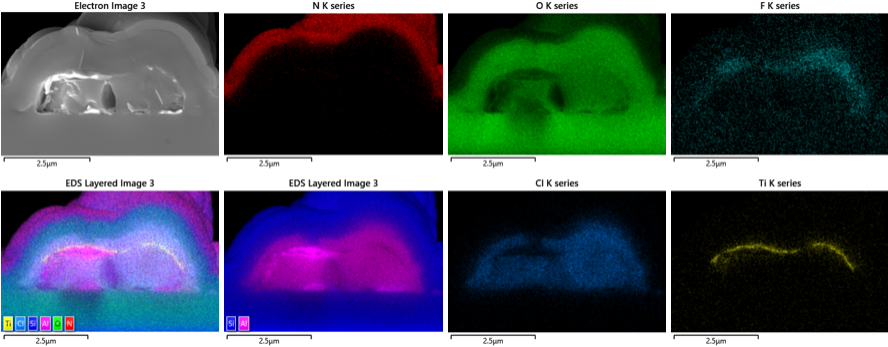
图1 功率器件中失效部位(Al 金属)的形貌及元素分布
从电子图像中,我们可以清晰的看见中间 Al 金属的空洞。通过能谱 EDS 检测到的元素面分布图可见,中间的 Al 金属中也有大量 O 元素的信号,这表明该失效点的 Al 金属已经发生氧化。从 Ti 的元素分布图可知,本应连续分布在 Al 金属表面的 Ti/TiN 介质层并不连续,中间出现了缺失。此外,Al 金属的分布越过了介质层,且在 Al 金属处还检测出了微量的 Cl 和 F,而这两个元素在结构设计中不存在。反观半导体工艺制程,F 是某些光刻胶中的主要成分,Cl 可能来自于剥离光刻胶的溶液。综合以上信息,我们可以推断出该坏点的失效机理与光刻胶清洗不彻底有关。
上面的结果,显示了能谱仪 EDS 可以作为失效分析的一个手段,帮助寻找失效原因。但是,在 EDS 的面分布中,可能会存在诸如重叠峰和信号量起伏造成的影响。比如此案例中的 F 元素,含量很少,它的分布就极易受其他含量多的元素(如 Si 和 O)的影响,其结果如图 2 中左上图 Smartmap 中所示,F 在整个分析区域都有分布,这显然是错误的信息,严重时甚至会影响失效原因的判断。因此,需要通过 AZtecLive 能谱软件做背底扣除(信号量起伏造成的分布图偏差)及重叠峰剥离获得真实的元素分布图。牛津仪器的 AZtecLive 软件使用 Tru-Q® 技术,可以一键消除背底对所有元素分布的影响,输出真实的元素分布图 TruMap,如图 2 右上图中 F 的 TruMap 结果,为真实的 F 元素分布图。


图 2 样品中 F 的分布,左上图为不扣除背底影响的 SmartMap,右上图为扣除背底后真实的 F 分布情况,下图为样品的谱图及 F 附近区域的放大显示,背底对 F 峰干扰较明显。
通过该案例,我们展示了现代大面积能谱仪 UltimMax170 在半导体器件失效分析中的应用,也了解到在进行 EDS 分析时,含量多的元素会对含量少且有偏聚的元素的影响,因此需要软件能够智能地对背底的影响进行剥离,输出正确的元素分布图。
牛津仪器纳米分析部近年来推出的 Ultim Max 系列能谱具有操作简单灵活、对低含量及轻元素敏感、适配各种探头(STEM、EBSD 和 BSD)等特点,可以应用于更多材料,帮助研究者了解材料内部的元素构成及分布,建立更全面的微观—宏观联系。
We send out monthly newsletters keeping you up to date with our latest developments such as webinars, new application notes and product updates.
 公安机关备案号31010402003473
公安机关备案号31010402003473